HCE-300
Product : HCE-300
제품명 : HCE-300
반도체 및 디스플레이 미세회로 공정에서 구리 또는 구리 합금을 선택적이고 균일하게 제거할 수 있고,
빠른 에칭속도를 유지하면서도 회로 측면 보호 기능으로 Undercut을 최소화 할 수 있는 구리 에칭제
제품 정보
| 항목 | 특징 |
|---|---|
| 성분 타입 | 과산화수소-Acid계 |
| 금속 선택성 | 구리 또는 구리 합금에 대해 선택적으로 균일한 에칭력을 제공 |
| 에칭 속도 | 빠른 에칭 속도를 유지하면서 정밀한 미세구조 형성에 유리 |
| 표면 조도 | 균일한 에칭으로 미세하고 균일한 회로 표면 조도를 유지 |
| 오염물 제거 능력 | 동 표면의 산화 피막, 레지스트 잔유물 등 유.무기 오염물 제거력 우수 |
메커니즘
과산화수소에 의한 구리 표면의 산화
표면 산화된 구리를 Acid가 떼어냄
떨어져 나와 이온화된 구리를 착화제 성분이 안정화 시킴
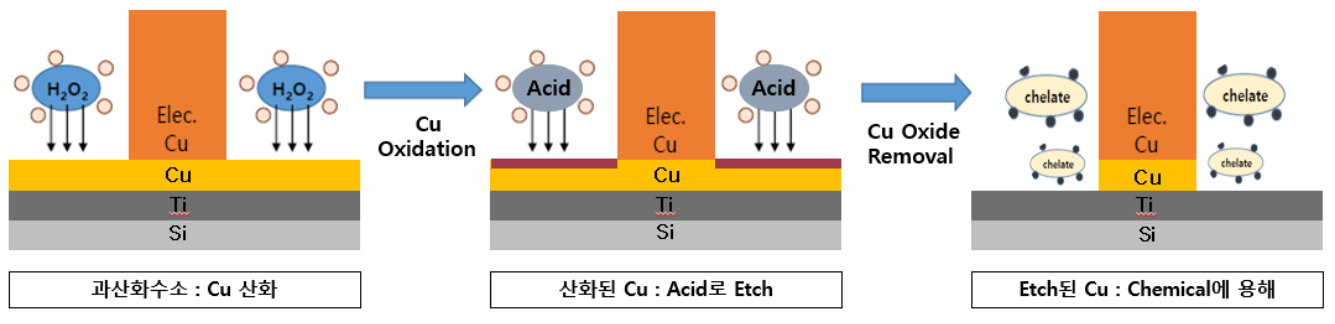
WLCSP용 Sputtered Cu Layer Etch Chemical
두께범위
(Thk. : 100~500nm)
친환경(F-free)
공정 적용
Metal Damage Free
(SnAg, Ni, Au, Al, Ti, Ti-W)
타사 대비
미세 정밀 패턴 구현 가능
우수한
Process capacity
| 제품명 | 평가 항목 | Plated SnAg Bump | Cu Pillar Bump | WLCSP RDL |
|---|---|---|---|---|
| 타사 제품 | E/R (nm/sec) | 3 | 3 | 3 |
| Undercut (nm) (O/E : 200%) |
327.9 | 772.0 | 373.6 | |
| HCE-300 | E/R (nm/sec) | 4.5 | 4.5 | 4.5 |
| Undercut (nm) (O/E : 200%) |
224.6 (-31.5%) | 373.6 (-51.6%) | 145.3 (-61%) |
| Plated SnAg Bump | Cu Pillar Bump | WLCSP RDL | |
|---|---|---|---|
| Wafer |  |
 |
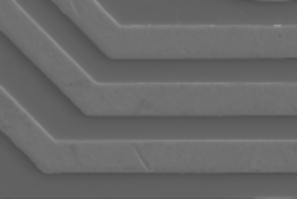 |
| 타사 제품 Undercut |
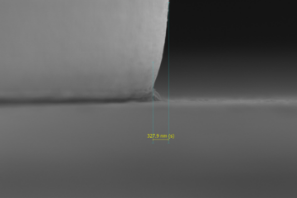 |
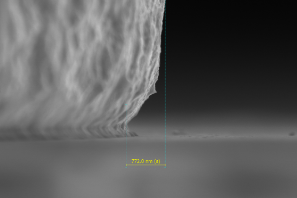 |
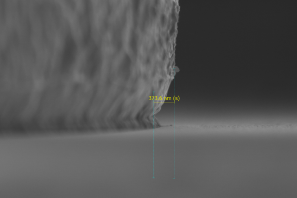 |
| 327.9 nm | 772.0 nm | 373.6 nm | |
| HCE-300 Undercut |
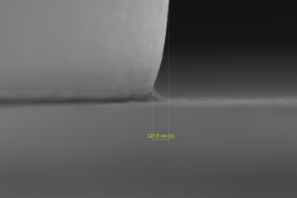 |
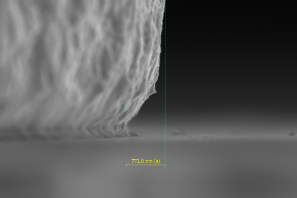 |
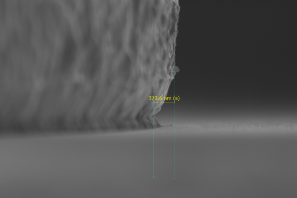 |
| 224.6 nm | 373.6 nm | 145.3 nm |
시료 종류 별 E/R 및 Undercut 비교

